Սիլիցիումի կարբիդ (SiC) էպիտաքսիա
Էպիտաքսիալ սկուտեղը, որը պահում է SiC ենթաշերտը SiC էպիտաքսիալ շերտը աճեցնելու համար, տեղադրված է ռեակցիայի խցիկում և ուղղակիորեն շփվում է վաֆլի հետ:

Վերին կիսալուսնի հատվածը կրող է Sic epitaxy սարքավորման ռեակցիոն պալատի այլ պարագաների համար, մինչդեռ ստորին կիսալուսնի մասը միացված է քվարցային խողովակին, գազը ներմուծելով ընկալիչի հիմքը պտտելու համար: դրանք կառավարելի են ջերմաստիճանով և տեղադրվում են ռեակցիայի խցիկում՝ առանց վաֆլի հետ անմիջական շփման:

Si epitaxy

Սկուտեղը, որը պահում է Si ենթաշերտը Si epitaxial շերտը աճեցնելու համար, տեղադրված է ռեակցիայի խցիկում և ուղղակիորեն շփվում է վաֆլի հետ:

Նախատաքացման օղակը գտնվում է Si epitaxial ենթաշերտի սկուտեղի արտաքին օղակի վրա և օգտագործվում է տրամաչափման և ջեռուցման համար: Այն տեղադրված է ռեակցիայի խցիկում և ուղղակիորեն չի շփվում վաֆլի հետ:

Epitaxial susceptor, որը պահում է Si substrate-ը Si epitaxial շերտ աճեցնելու համար, տեղադրված է ռեակցիայի խցիկում և ուղղակիորեն շփվում է վաֆլի հետ:

Epitaxial տակառը հիմնական բաղադրիչներն են, որոնք օգտագործվում են տարբեր կիսահաղորդիչների արտադրության գործընթացներում, որոնք սովորաբար օգտագործվում են MOCVD սարքավորումներում, գերազանց ջերմային կայունությամբ, քիմիական դիմադրությամբ և մաշվածության դիմադրությամբ, շատ հարմար են բարձր ջերմաստիճանի գործընթացներում օգտագործելու համար: Այն կապվում է վաֆլիների հետ:
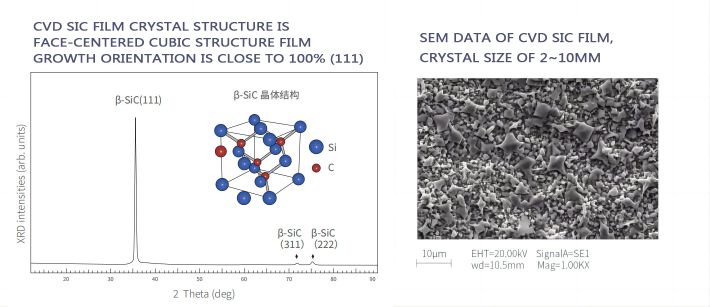
| Վերաբյուրեղացված սիլիցիումի կարբիդի ֆիզիկական հատկությունները | |
| Սեփականություն | Տիպիկ արժեք |
| Աշխատանքային ջերմաստիճան (°C) | 1600°C (թթվածնով), 1700°C (նվազեցնող միջավայր) |
| SiC բովանդակություն | > 99.96% |
| Անվճար Si բովանդակություն | <0,1% |
| Զանգվածային խտություն | 2,60-2,70 գ/սմ3 |
| Ակնհայտ ծակոտկենություն | < 16% |
| Սեղմման ուժը | > 600 ՄՊա |
| Սառը ճկման ուժ | 80-90 ՄՊա (20°C) |
| Տաք ճկման ուժ | 90-100 ՄՊա (1400°C) |
| Ջերմային ընդլայնում @1500°C | 4.70 10-6/°C |
| Ջերմահաղորդականություն @1200°C | 23 W/m•K |
| Էլաստիկ մոդուլ | 240 ԳՊա |
| Ջերմային ցնցումների դիմադրություն | Չափազանց լավ |
| Սիլիցիումի կարբիդի սինթերի ֆիզիկական հատկությունները | |
| Սեփականություն | Տիպիկ արժեք |
| Քիմիական բաղադրություն | SiC>95%, Si<5% |
| Զանգվածային խտություն | >3,07 գ/սմ³ |
| Ակնհայտ ծակոտկենություն | <0,1% |
| Խզման մոդուլը 20℃ | 270 ՄՊա |
| Խզման մոդուլը 1200℃ | 290 ՄՊա |
| Կարծրություն 20℃ | 2400 կգ/մմ² |
| Կոտրվածքի ամրություն 20% | 3,3 ՄՊա · մ1/2 |
| Ջերմային հաղորդունակություն 1200℃ | 45 w/m .K |
| Ջերմային ընդլայնում 20-1200℃ | 4,5 1 × 10 -6/℃ |
| Աշխատանքային առավելագույն ջերմաստիճան | 1400℃ |
| Ջերմային ցնցումների դիմադրություն 1200℃ | Լավ |
| CVD SiC ֆիլմերի հիմնական ֆիզիկական հատկությունները | |
| Սեփականություն | Տիպիկ արժեք |
| Բյուրեղյա կառուցվածք | FCC β փուլային պոլիբյուրեղային, հիմնականում (111) ուղղվածություն |
| Խտություն | 3,21 գ/սմ³ |
| Կարծրություն 2500 | (500 գ բեռ) |
| Հացահատիկի չափը | 2-10 մկմ |
| Քիմիական մաքրություն | 99,99995% |
| Ջերմային հզորություն | 640 J·kg-1· Կ-1 |
| Սուբլիմացիայի ջերմաստիճանը | 2700℃ |
| Ճկման ուժ | 415 ՄՊա RT 4-բալ |
| Յանգի մոդուլը | 430 Gpa 4pt թեքում, 1300℃ |
| Ջերմային հաղորդունակություն | 300W·m-1· Կ-1 |
| Ջերմային ընդլայնում (CTE) | 4,5×10-6 K -1 |
Հիմնական հատկանիշները
Մակերեւույթը խիտ է և առանց ծակոտիների:
Բարձր մաքրություն, ընդհանուր անմաքրության պարունակություն <20 ppm, լավ հերմետիկություն:
Բարձր ջերմաստիճանի դիմադրություն, ուժը մեծանում է օգտագործման ջերմաստիճանի բարձրացմամբ՝ հասնելով ամենաբարձր արժեքին 2750℃-ում, սուբլիմացիա՝ 3600℃:
Ցածր առաձգական մոդուլ, բարձր ջերմային հաղորդունակություն, ցածր ջերմային ընդարձակման գործակից և գերազանց ջերմային ցնցումների դիմադրություն:
Լավ քիմիական կայունություն, դիմացկուն է թթուների, ալկալիների, աղի և օրգանական ռեակտիվների նկատմամբ և չի ազդում հալած մետաղների, խարամի և այլ քայքայիչ միջավայրերի վրա: Այն զգալիորեն չի օքսիդանում 400 C-ից ցածր մթնոլորտում, իսկ օքսիդացման արագությունը զգալիորեն մեծանում է 800 ℃-ում:
Առանց բարձր ջերմաստիճաններում որևէ գազ արձակելու, այն կարող է պահպանել 10-7 մմ ս.ս. վակուում մոտ 1800°C ջերմաստիճանում:
Ապրանքի դիմում
Կիսահաղորդչային արդյունաբերության մեջ գոլորշիացման համար հալվող կարաս:
Բարձր հզորության էլեկտրոնային խողովակի դարպաս:
Խոզանակ, որը շփվում է լարման կարգավորիչի հետ:
Գրաֆիտային մոնոխրոմատոր ռենտգենյան ճառագայթների և նեյտրոնների համար:
Գրաֆիտի ենթաշերտերի տարբեր ձևեր և ատոմային կլանող խողովակի ծածկույթ:
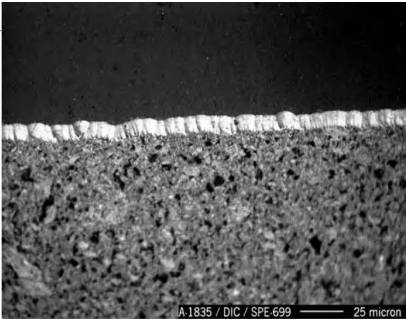
Պիրոլիտիկ ածխածնային ծածկույթի ազդեցություն 500X մանրադիտակի տակ, անձեռնմխելի և կնքված մակերեսով:
TaC ծածկույթը նոր սերնդի բարձր ջերմաստիճանի դիմացկուն նյութ է, որն ունի ավելի լավ բարձր ջերմաստիճանի կայունություն, քան SiC-ը: Որպես կոռոզիոն դիմացկուն ծածկույթ, հակաօքսիդիչ ծածկույթ և մաշվածության դիմացկուն ծածկույթ, կարող է օգտագործվել 2000C-ից բարձր միջավայրում, լայնորեն օգտագործվում է օդատիեզերական գերբարձր ջերմաստիճանի տաք ծայրամասերում, երրորդ սերնդի կիսահաղորդչային մեկ բյուրեղային աճի դաշտերում:



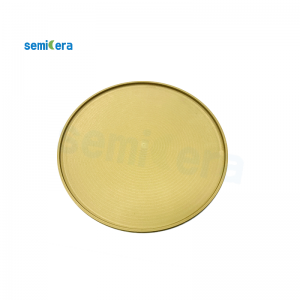
| TaC ծածկույթի ֆիզիկական հատկությունները | |
| Խտություն | 14.3 (գ/սմ3) |
| Հատուկ արտանետում | 0.3 |
| Ջերմային ընդարձակման գործակիցը | 6.3 10/Կ |
| Կարծրություն (HK) | 2000 HK |
| Դիմադրություն | 1x10-5 Օմ*սմ |
| Ջերմային կայունություն | <2500℃ |
| Գրաֆիտի չափը փոխվում է | -10~-20մմ |
| Ծածկույթի հաստությունը | ≥220um բնորոշ արժեք (35um±10um) |
Պինդ CVD SILICON CARBIDE մասերը ճանաչված են որպես հիմնական ընտրություն RTP/EPI օղակների և հիմքերի և պլազմային փորագրման խոռոչի մասերի համար, որոնք գործում են համակարգի պահանջվող աշխատանքային ջերմաստիճանում (> 1500°C), մաքրության պահանջները հատկապես բարձր են (> 99,9995%): և արդյունավետությունը հատկապես լավ է, երբ քիմիական նյութերի դիմադրությունը հատկապես բարձր է: Այս նյութերը չեն պարունակում երկրորդական փուլեր հացահատիկի եզրին, ուստի դրանց բաղադրիչներն ավելի քիչ մասնիկներ են արտադրում, քան մյուս նյութերը: Բացի այդ, այս բաղադրիչները կարող են մաքրվել տաք HF/HCI-ի միջոցով՝ քիչ քայքայվածությամբ, ինչը հանգեցնում է ավելի քիչ մասնիկների և ավելի երկար ծառայության ժամկետի: